Perché e come applicare i transistor a effetto di campo GaN per applicazioni di potenza efficienti, a tensione più elevata e in in modalità commutata
Contributo di Editori nordamericani di DigiKey
2023-01-26
L'efficienza energetica è una priorità per i sistemi elettronici a fronte di requisiti sociali e normativi. In particolare, per applicazioni che vanno dai veicoli elettrici (EV) alle comunicazioni ad alta tensione e alle infrastrutture industriali, l'efficienza della conversione di potenza e la densità di potenza sono fondamentali per il successo del progetto.
Per soddisfare questi requisiti, i progettisti di sistemi di alimentazione in modalità commutata devono abbandonare i classici transistor a effetto di campo metallo-ossido (MOSFET) e i transistor bipolari a gate isolato (IGBT), che stanno rapidamente raggiungendo i loro limiti teorici.
I progettisti devono ora considerare dispositivi basati su materiali ad ampio bandgap (WBG) come il nitruro di gallio (GaN). I dispositivi GaN commutano più velocemente dei dispositivi Si, gestiscono livelli di tensione e di potenza più elevati, sono molto più piccoli per un dato livello di potenza e funzionano con un'efficienza molto più elevata.
Questo articolo esaminerà le basi dei FET GaN, mostrerà i loro vantaggi rispetto ai tradizionali dispositivi Si nei circuiti di alimentazione in modalità commutata, introdurrà esempi reali di Nexperia e discuterà le loro applicazioni.
Principi base dei FET GaN
Gli elementi fondamentali dei circuiti di conversione di potenza sono gli interruttori a semiconduttore ad alta tensione. I progettisti si sono concentrati sul miglioramento delle prestazioni di questi dispositivi: ridurre le perdite di conduzione grazie alla riduzione della resistenza in serie nello stato On, ridurre le perdite di commutazione grazie all'aumento delle velocità di transizione e ridurre gli effetti parassiti. In generale, questi sforzi di progettazione hanno avuto successo per i MOSFET e gli IGBT al silicio, ma il ritmo di miglioramento sta rallentando mentre il funzionamento di questi dispositivi raggiunge i limiti teorici.
Di conseguenza, negli ultimi anni si è assistito all'introduzione di dispositivi WBG che utilizzano il carburo di silicio (SiC) e GaN, fino a raggiungere la produzione in serie. Questi dispositivi offrono intervalli della tensione di funzionamento più elevati, tempi di commutazione più brevi e una maggiore efficienza.
Il bandgap di un semiconduttore è l'energia minima necessaria per eccitare gli elettroni e liberarli dallo stato legato a quello libero per condurre elettricità (Tabella 1).
|
Tabella 1: Riassunto delle proprietà chiave che distinguono i semiconduttori ad ampio bandgap, come il GaN e il SiC, dal Si. (Tabella per gentile concessione di Art Pini)
I dispositivi realizzati con semiconduttori ad ampio bandgap possono funzionare a tensioni, frequenze e temperature molto più elevate rispetto ai materiali semiconduttori convenzionali come il Si. Il bandgap più ampio è particolarmente importante per consentire ai dispositivi di funzionare a temperature molto superiori. L'elevata tolleranza alla temperatura significa che, in condizioni normali, questi dispositivi possono funzionare a livelli di potenza molto maggiori. I semiconduttori WBG con un campo elettrico critico più elevato e una mobilità più alta presentano una resistenza nello stato On drain-source (RDSOn) più bassa, che riduce le perdite di conduzione.
La maggior parte dei materiali ad ampio bandgap ha anche un'elevata velocità degli elettroni liberi, che consente loro di lavorare a velocità di commutazione più elevate.
Rispetto al Si, che ha un bandgap di 1,12 eV, il GaN e il SiC sono semiconduttori con bandgap circa tre volte superiori, rispettivamente di 3,4 eV e 3,3 eV. Ciò significa che entrambi possono supportare tensioni e frequenze più elevate.
La maggiore mobilità degli elettroni del GaN lo rende molto più adatto ad applicazioni ad alte prestazioni e ad alta frequenza. Le velocità di commutazione e le frequenze operative più elevate accettate dai FET di potenza GaN consentono di migliorare il controllo del segnale, di progettare filtri passivi con frequenze di taglio più elevate e di ridurre le correnti di ripple. Ciò consente di utilizzare induttori, condensatori e trasformatori più piccoli, con conseguente riduzione complessiva delle dimensioni e del peso.
I FET GaN sono chiamati transistor ad alta mobilità elettronica (HEMT). L'elevata mobilità degli elettroni è una funzione della struttura del FET (Figura 1).
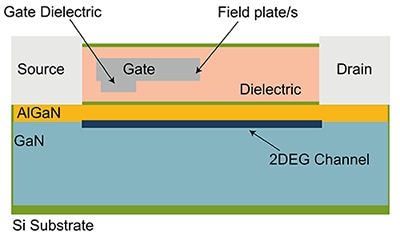 Figura 1: Sezione trasversale di un FET GaN basato su un substrato di Si. (Immagine per gentile concessione di Nexperia)
Figura 1: Sezione trasversale di un FET GaN basato su un substrato di Si. (Immagine per gentile concessione di Nexperia)
I FET GaN utilizzano gli impianti di produzione CMOS al silicio esistenti, e questo li rende economicamente vantaggiosi. Uno strato di GaN viene formato sul substrato di Si depositando uno strato germe e uno strato graduato di GaN e nitruro di gallio e alluminio (AlGaN) come strato di isolamento (non mostrato nello schema) prima che cresca lo strato di GaN puro. Un secondo strato di AlGaN viene depositato sopra lo strato di GaN. In questo modo si crea una polarizzazione piezoelettrica, con un eccesso di elettroni generati immediatamente sotto AlGaN, che è un canale altamente conduttivo. Questo eccesso di elettroni è noto come gas di elettroni bidimensionale (2DEG). Il nome riflette l'altissima mobilità degli elettroni in questo strato.
Sotto il gate si forma una regione di carica spaziale. Il funzionamento del gate è simile a quello di un MOSFET di potenza al silicio a canale N, in modalità potenziata. Una tensione positiva applicata al gate di questo dispositivo lo accende.
Questa struttura viene ripetuta più volte per formare un dispositivo di potenza. Il risultato finale è una soluzione fondamentalmente semplice, elegante ed economica per la commutazione di potenza.
Per ottenere un dispositivo a tensione più elevata, si aumenta la distanza tra il drain e il gate. Dato che la resistività del GaN 2DEG è molto bassa, l'impatto sulla resistenza aumentando la capacità di tensione di blocco, è molto più basso che nei dispositivi al silicio.
I FET GaN possono funzionare in una di due configurazioni: modalità potenziata o modalità depletion. I FET in modalità potenziata sono normalmente spenti, quindi per accendere il FET è necessario applicare al gate una tensione positiva rispetto al drain/source. I FET in modalità depletion sono normalmente attivi, quindi per spegnerli è necessario applicare una tensione di gate negativa rispetto al drain/source. I FET in modalità depletion sono problematici in un sistema di alimentazione, perché è necessario applicare una polarizzazione negativa al FET in modalità depletion GaN prima di alimentare il sistema.
Un modo per ovviare a questo problema consiste nel combinare un FET al silicio a bassa tensione con un FET GaN in modalità depletion in una configurazione circuitale cascode (Figura 2).
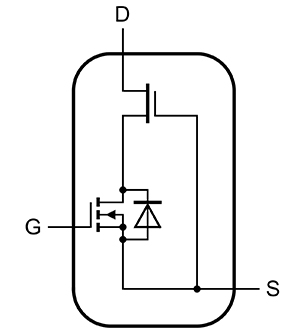 Figura 2: Un MOSFET al silicio a bassa tensione in una configurazione cascode con un FET GaN in modalità depletion realizza una struttura robusta del gate in Si con le migliori caratteristiche di clock ad alta tensione del dispositivo GaN, e - nel caso di un FET GaN in modalità depletion - consente anche di avere il dispositivo composito spento all'accensione. (Immagine per gentile concessione di Nexperia)
Figura 2: Un MOSFET al silicio a bassa tensione in una configurazione cascode con un FET GaN in modalità depletion realizza una struttura robusta del gate in Si con le migliori caratteristiche di clock ad alta tensione del dispositivo GaN, e - nel caso di un FET GaN in modalità depletion - consente anche di avere il dispositivo composito spento all'accensione. (Immagine per gentile concessione di Nexperia)
Il circuito cascode utilizza la struttura del gate del MOSFET al Si, che presenta i vantaggi in termini di limiti di pilotaggio del gate più elevati rispetto ai CI di pilotaggio del gate del MOSFET esistenti e di un FET GaN in modalità depletion spento all'accensione.
Una delle caratteristiche principali dei FET GaN è la loro elevata efficienza. Ciò è dovuto alla bassa resistenza in serie, che riduce le perdite di conduzione, ai tempi di commutazione più brevi, che riducono le perdite di commutazione, e alla minore carica di recupero inverso, che spiega le basse perdite di recupero inverso.
Utilizzando una comune topologia di convertitore boost a semiponte, è possibile confrontare le efficienze dei FET GaN e dei MOSFET Si (Figura 3).
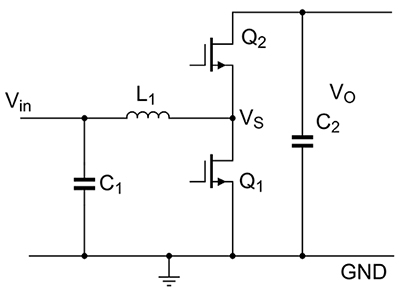 Figura 3: Schema di un convertitore boost a semiponte utilizzato per confrontare le efficienze dei MOSFET e dei FET GaN scambiando i transistor Q1 e Q2 con ciascun tipo. (Immagine per gentile concessione di Nexperia)
Figura 3: Schema di un convertitore boost a semiponte utilizzato per confrontare le efficienze dei MOSFET e dei FET GaN scambiando i transistor Q1 e Q2 con ciascun tipo. (Immagine per gentile concessione di Nexperia)
Il convertitore boost ha una tensione di ingresso di 240 V, l'uscita è di 400 V e la frequenza di commutazione è di 100 kHz. Le efficienze e le perdite sono confrontate su un intervallo di potenza fino a 3500 W (Figura 4).
 Figura 4: Confronto dell'efficienza e della perdita di potenza tra FET GaN e MOSFET in un circuito identico, che mostra i vantaggi dei FET GaN. (Immagine per gentile concessione di Nexperia)
Figura 4: Confronto dell'efficienza e della perdita di potenza tra FET GaN e MOSFET in un circuito identico, che mostra i vantaggi dei FET GaN. (Immagine per gentile concessione di Nexperia)
I FET GaN hanno un'efficienza superiore del 20% circa rispetto ai MOSFET e la perdita di potenza è inferiore di circa tre volte. A 2000 W, la perdita nei MOSFET è di circa 62 W; nei FET GaN è di soli 19 W. Ciò significa che il sistema di raffreddamento può essere più piccolo, migliorando così l'efficienza volumetrica del convertitore boost.
Meno evidente è che la misurazione è stata effettuata fino a quasi 3500 W per il FET GaN a causa del suo limite di tensione massima superiore. Per questo motivo, il FET GaN presenta un netto vantaggio.
Primi passi con il GaN per tensioni più elevate
Per le applicazioni a tensione più elevata, Nexperia offre due FET GaN da 650 V, GAN063-650WSAQ e GAN041-650WSBQ. Entrambi sono FET a canale N normalmente spenti. GAN063-650WSAQ è in grado di gestire una tensione massima drain/source di 650 V e può sostenere un transitorio (con una larghezza di impulso inferiore a un microsecondo) di 800 V. La corrente di drain è di 34,5 A e la potenza dissipata è di 143 W a 25 °C. La resistenza nello stato On drain/source è tipicamente di 50 mΩ, con un limite massimo di 60 mΩ.
GAN041-650WSBQ ha la stessa tensione massima drain/source di 650 V e lo stesso limite transitorio di 800 V. Si differenzia per la capacità di gestire una corrente di drain massima di 47,2 A e una potenza massima dissipata di 187 W a temperatura ambiente. La resistenza tipica del canale è di 35 mΩ, con un massimo di 41 mΩ.
La Figura 5 mostra un progetto di riferimento Nexperia che utilizza GAN063-650WSAQ in una configurazione a semiponte.
 Figura 5: Progetto consigliato per uno stadio di potenza a semiponte che utilizza i FET GaN GAN063-650WSA. Lo schema mostra solo il driver FET, lo stadio di uscita a semiponte e i relativi componenti. (Immagine per gentile concessione di Nexperia)
Figura 5: Progetto consigliato per uno stadio di potenza a semiponte che utilizza i FET GaN GAN063-650WSA. Lo schema mostra solo il driver FET, lo stadio di uscita a semiponte e i relativi componenti. (Immagine per gentile concessione di Nexperia)
Lo schema mostra il gate driver Si8230 a doppio isolamento alto/basso, utilizzato per pilotare i gate dei FET GaN. L'uscita del gate driver è collegata al gate tramite un resistore di gate da 30 Ω, necessaria per tutti i dispositivi GaN. Il resistore di gate controlla il tempo di carica della capacità di gate, influenzando le prestazioni di commutazione dinamica. Anche le reti R-C tra drain e source dei FET contribuiscono a controllare le prestazioni di commutazione. I livelli di pilotaggio del gate per il FET GaN sono compresi tra 0 e 10-12 V.
L'elevata velocità di commutazione dei FET GaN (tipicamente nell'intervallo di 10-11 ns) richiede un layout accurato per ridurre al minimo l'induttanza parassita e l'uso di soppressori RC per smorzare la sovraoscillazione dovuta ai transitori di tensione e corrente. Tra l'alimentazione ad alta tensione e la massa sono presenti più soppressori RC (da R17 a 19 e da C33 a 35). I soppressori riducono la sovraoscillazione causata dall'interazione tra il FET GaN e la rete di bypass. I soppressori devono essere collegati il più vicino possibile al drain del FET high-side. Sono implementati con resistori a montaggio superficiale e condensatori ceramici a bassa resistenza equivalente in serie (ESR) per ridurre al minimo l'induttanza dei conduttori.
La rete di componenti formata da R4, D1, C12 e C13 è un alimentatore bootstrap per il gate driver high-side. D1 deve essere un diodo veloce e a bassa capacità, perché la sua capacità di giunzione contribuisce alla perdita di commutazione. R4 limita la corrente di carica di inserzione; un valore compreso tra 10 e 15 Ω è ideale.
Conclusione
Dai veicoli elettrici alle comunicazioni e alle infrastrutture industriali, l'esigenza di una maggiore efficienza di conversione e densità di potenza richiede qualcosa di diverso rispetto alle classiche strutture in Si. Come si è visto, i FET GaN rappresentano un passo avanti per i progetti di prossima generazione, offrendo tensioni di funzionamento più elevate, tempi di commutazione più brevi e una maggiore efficienza. I componenti disponibili, in alcuni casi supportati da progetti di riferimento, aiutano i progettisti a mettersi rapidamente al lavoro.

Esonero della responsabilità: le opinioni, le convinzioni e i punti di vista espressi dai vari autori e/o dai partecipanti al forum su questo sito Web non riflettono necessariamente le opinioni, le convinzioni e i punti di vista di DigiKey o le sue politiche.