Come utilizzare i MOSFET SiC di terza generazione in progetti di potenza per prestazioni ed efficienza più elevate
Contributo di Editori nordamericani di DigiKey
2022-11-02
La ricerca di una maggiore efficienza, di dimensioni ridotte e di prestazioni più elevate è inarrestabile nelle applicazioni di alimentazione come driver di motori industriali, inverter/convertitori c.a./c.c. e c.c./c.c., caricabatterie e sistemi di immagazzinaggio dell'energia. Questi rigorosi requisiti prestazionali hanno superato le capacità dei MOSFET al silicio (Si) e hanno visto il sorgere di nuove architetture di transistor basate sul carburo di silicio (SiC).
Sebbene questi nuovi dispositivi offrano vantaggi significativi in termini di prestazioni, i progettisti hanno fatto bene a diffidare dei dispositivi SiC di prima generazione, a causa di varie limitazioni e incertezze applicative. I dispositivi di seconda generazione hanno portato specifiche migliori e una migliore comprensione delle particolarità del dispositivo. Con l'aumento delle prestazioni dei MOSFET SiC e l'intensificarsi delle pressioni sull'abbattimento del time-to-market, i progettisti hanno utilizzato questi nuovi dispositivi per soddisfare gli obiettivi. Più recentemente, i dispositivi di terza generazione stanno dimostrando la maturità dei dispositivi di alimentazione basati su SiC. Questi dispositivi offrono agli utenti miglioramenti in tutti i parametri chiave, sfruttando al contempo l'esperienza di progettazione e la relativa competenza delle generazioni precedenti.
Questo articolo confronta il Si con il SiC, prima di discutere lo sviluppo e la migrazione verso i MOSFET SiC di terza generazione. Presenta poi esempi reali di Toshiba Semiconductor and Storage Corp. (Toshiba) per mostrare come questi dispositivi possano aiutare i progettisti a fare progressi significativi nella progettazione dei sistemi di alimentazione.
Silicio e SiC
Negli ultimi decenni, il MOSFET basati sul silicio ha trasformato la progettazione dei sistemi di alimentazione, dagli alimentatori di base agli inverter, fino ai comandi dei motori. Insieme al transistor bipolare a gate isolato (IGBT) - un semiconduttore funzionalmente simile ma con caratteristiche costruttive e attributi molto diversi - il MOSFET Si ottimizzato per la commutazione ha permesso la transizione dalla tradizionale e inefficiente conversione e gestione dell'energia basata su topologie lineari, a un approccio molto più efficiente e compatto che utilizza il controllo a commutazione.
La maggior parte di questi progetti utilizza una forma della modulazione della larghezza di impulso (PWM) per fornire e mantenere la tensione, la corrente o il valore di potenza desiderati in una disposizione di retroazione ad anello chiuso. Con l'aumento dell'uso dei MOSFET al silicio, sono aumentate anche le esigenze di utilizzo. Inoltre, i nuovi obiettivi di efficienza (molti dei quali basati su mandati normativi), i mercati dei veicoli elettrici e del controllo più intelligente dei motori, la conversione di potenza per le energie rinnovabili e i relativi sistemi di immagazzinaggio dell'energia, hanno spinto questi MOSFET a fare di più e meglio.
Di conseguenza, gli sforzi rivolti alla ricerca e allo sviluppo hanno migliorato le prestazioni dei MOSFET basati sul silicio, ma i ricercatori si sono resi ben presto conto che stavano raggiungendo il punto in cui "il gioco non vale la candela". Fortunatamente esisteva un'alternativa, in teoria, basata su dispositivi di commutazione di potenza che utilizzavano come substrato il SiC anziché il solo silicio.
Perché utilizzare SiC?
Per ragioni di natura fisica, il SiC ha tre proprietà elettriche fondamentali che differiscono in modo significativo da quelle del solo silicio, ciascuna delle quali offre vantaggi operativi; ma ve ne sono anche di più sottili (Figura 1).
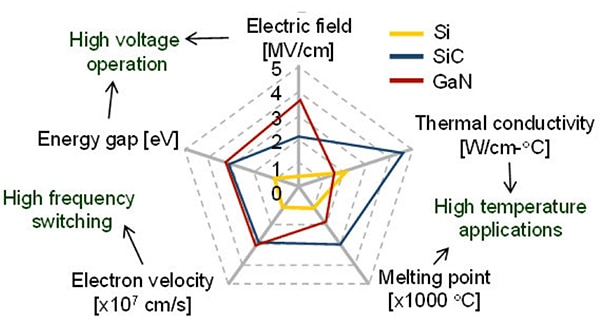 Figura 1: Confronto approssimativo tra le principali proprietà materiali del SiC e quelle dei materiali solidi Si e nitruro di gallio (GaN). (Immagine per gentile concessione di Researchgate)
Figura 1: Confronto approssimativo tra le principali proprietà materiali del SiC e quelle dei materiali solidi Si e nitruro di gallio (GaN). (Immagine per gentile concessione di Researchgate)
Le tre caratteristiche principali sono:
- Valori più alti per la tensione critica di rottura del campo elettrico, pari a circa 2,8 megavolt al centimetro (MV/cm) a fronte di 0,3 MV/cm; il funzionamento a una determinata tensione nominale richiede pertanto uno strato molto più sottile, con la conseguente riduzione della resistenza nello stato On (RDSon) drain/source.
- Maggiore conducibilità termica, che consente una densità di corrente più elevata in un'area di sezione trasversale.
- Banda proibita più larga (la differenza di energia in elettronvolt tra la parte superiore della banda di valenza e il fondo della banda di conduzione nei semiconduttori (e isolatori) che determina una corrente di dispersione più bassa alle alte temperature. È per questa ragione che i diodi e i transistor a effetto di campo (FET) in SiC sono spesso chiamati "dispositivi ad ampia banda proibita" (WBG).
Di conseguenza, i dispositivi basati su SiC possono bloccare tensioni fino a dieci volte superiori rispetto alle strutture in solo silicio, possono commutare circa dieci volte più velocemente e hanno una RDSon pari o inferiore alla metà a 25 °C, a parità di area di die (ovviamente tutti i dati sono approssimativi). Inoltre, la perdita legata alla commutazione in fase di spegnimento dei dispositivi SiC è minore, perché non vi è una corrente di coda dannosa. Al contempo, la loro capacità di funzionare a temperature di ben lunga superiori ai 200°°C circa rispetto ai 125°°C semplifica gli aspetti di progettazione e gestione termica.
Grazie alle loro caratteristiche prestazionali e ai loro progressi, i dispositivi SiC hanno assunto un posto di rilievo nella matrice delle applicazioni che soppesano alimentazione e velocità, insieme agli IGBT, ai MOSFET al silicio e ai dispositivi GaN (Figura 2).
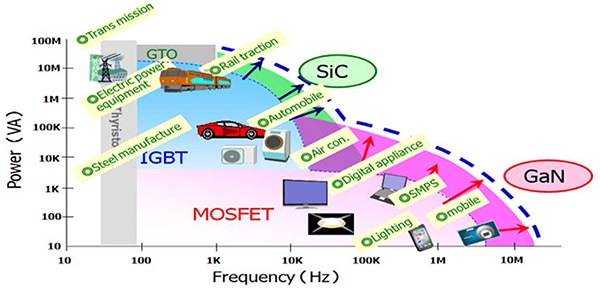 Figura 2: Gli attributi prestazionali dei MOSFET SiC li rendono adatti a un'ampia gamma di applicazioni con una serie di potenze e frequenze nominali. (Immagine per gentile concessione di Toshiba)
Figura 2: Gli attributi prestazionali dei MOSFET SiC li rendono adatti a un'ampia gamma di applicazioni con una serie di potenze e frequenze nominali. (Immagine per gentile concessione di Toshiba)
Il percorso che ha portato dalla scienza dei materiali SiC e dalla fisica dei dispositivi ai MOSFET SiC commerciali non è stato né rapido né facile (Figura 3). Dopo un'intensa attività di ricerca e produzione, nel 2001 sono stati introdotti i primi dispositivi basati su SiC, i diodi Schottky. Nei due decenni successivi, il settore ha sviluppato e rilasciato volumi di produzione di MOSFET SiC di prima, seconda e terza generazione. Ogni generazione offre miglioramenti mirati in parametri specifici, con compromessi un po' diversi.
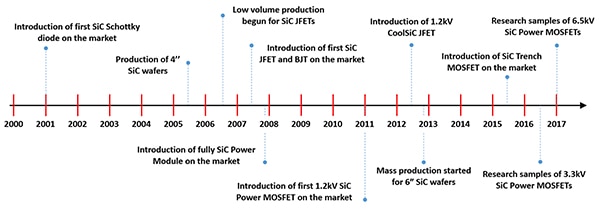 Figura 3: La storia dei dispositivi commerciali basati su SiC inizia con i primi diodi Schottky SiC, apparsi nel 2001. (Immagine per gentile concessione di IEEE Transactions on Industrial Electronics, 2017)
Figura 3: La storia dei dispositivi commerciali basati su SiC inizia con i primi diodi Schottky SiC, apparsi nel 2001. (Immagine per gentile concessione di IEEE Transactions on Industrial Electronics, 2017)
È importante far chiarezza sulla terminologia: proprio come i loro predecessori in silicio, i FET basati su SiC sono MOSFET. In senso ampio, le loro strutture fisiche interne sono simili e si tratta in entrambi i casi di dispositivi a tre terminali con collegamenti alla sorgente, al drain e al gate. La differenza tra loro è quella indicata dal nome: i FET in SiC utilizzano il carburo di silicio come materiale base al posto del solo silicio.
Iniziare con la prima e la seconda generazione
Sono molti i parametri che caratterizzano le prestazioni di un dispositivo di commutazione. Tra i numerosi parametri statici vi sono la massima tensione di funzionamento e la massima corrente nominale, oltre a due cifre di merito (FoM) statiche: la RDSon e la massima temperatura di funzionamento, che sono correlate alla capacità di gestione della potenza per una determinata dimensione del die e del contenitore.
In quanto dispositivi di commutazione, anche i parametri dinamici sono fondamentali, poiché sono necessari per valutare le perdite di commutazione. La FoM dinamica più citata è il prodotto della RDSon e della carica del gate, RDSon × Qg, mentre una sempre più importante è la carica di recupero inversa, Qrr. Il dimensionamento e le capacità del gate driver necessario per fornire correttamente la corrente di source e drain al dispositivo di commutazione - e farlo senza sovraelongazione, sovraoscillazione o altre distorsioni - sono determinati principalmente da queste FoM.
L'uso e la crescita del mercato dei dispositivi SiC di prima generazione sono stati frenati da problemi di affidabilità. Uno di questi riguarda i diodi a semiconduttore p-n, che sono posizionati tra la fonte di alimentazione e il drain di un MOSFET di potenza. La tensione applicata al diodo a semiconduttore p-n lo eccita, provocando una variazione della resistenza nello stato On che compromette l'affidabilità del dispositivo.
La seconda generazione di Toshiba ha modificato la struttura di base del dispositivo SiC utilizzando un diodo a barriera di Schottky (SBD) embedded nel MOSFET per risolvere in larga misura questo problema (Figura 4). Questo ha migliorato l'affidabilità di oltre un ordine di grandezza. La nuova struttura ha impedito l'eccitazione del diodo a semiconduttore p-n posizionando l'SBD in parallelo ad esso all'interno della cella. La corrente passa attraverso l'SBD embedded perché la sua tensione nello stato On è inferiore a quella del diodo a semiconduttore p-n, sopprimendo così alcune variazioni della RDSon e il degrado dell'affidabilità del MOSFET.
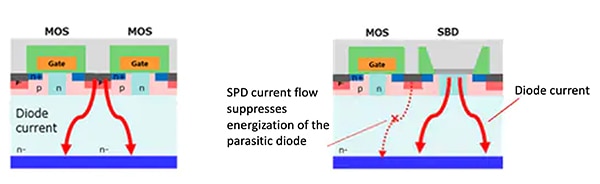 Figura 4: A differenza del tipico MOSFET SiC senza diodo a barriera di Schottky (SBD) interno (a sinistra), quello che ne è dotato (a destra) può ridurre al minimo l'eccitazione del diodo a semiconduttore p-n parassita. (Immagine per gentile concessione di Toshiba)
Figura 4: A differenza del tipico MOSFET SiC senza diodo a barriera di Schottky (SBD) interno (a sinistra), quello che ne è dotato (a destra) può ridurre al minimo l'eccitazione del diodo a semiconduttore p-n parassita. (Immagine per gentile concessione di Toshiba)
I MOSFET con SBD embedded erano già in uso, ma solo in prodotti ad alta tensione, come i dispositivi da 3,3 kV, poiché l'SBD embedded faceva sì che la resistenza nello stato On salisse a un livello che solo i prodotti ad alta tensione possono tollerare. Toshiba ha regolato diversi parametri del dispositivo e ha scoperto che il rapporto dell'area SBD in un MOSFET è la chiave per sopprimere l'aumento della RDSon. Ottimizzando il rapporto SBD, Toshiba ha ideato un MOSFET SiC di classe 1,2 kV con un notevole miglioramento dell'affidabilità.
Tuttavia, come nel caso di molti miglioramenti, c'erano dei compromessi. Se da un lato la nuova struttura del dispositivo ha migliorato significativamente l'affidabilità, dall'altro ha avuto un effetto negativo su due FoM. Aumenta la RDSon nominale e la RDSon × Qg, riducendo le prestazioni del MOSFET. Per compensare e ridurre la resistenza nello stato On, i MOSFET SiC di seconda generazione hanno aumentato l'area del die, ma questo ha fatto lievitare i costi.
La terza generazione dimostra una vera maturità
Riconoscendo questo problema, Toshiba ha sviluppato una terza generazione di dispositivi MOSFET SiC, la famiglia TWXXXN65C/TWXXXN120C. Questi dispositivi hanno ottimizzato la struttura dello strato di diffusione della corrente per ridurre le dimensioni della cella e offrire una tensione nominale più elevata, una commutazione più rapida e una minore resistenza nello stato On.
La RDSon si riduce in parte riducendo la resistenza di diffusione (Rspread). La corrente SBD viene aumentata iniettando azoto nella parte inferiore dell'ampia regione di diffusione di tipo P (P-well) del MOSFET SiC. Toshiba ha anche ridotto la regione JFET e iniettato azoto per ridurre la capacità di retroazione e la resistenza JFET. Di conseguenza, la capacità di retroazione è stata ridotta senza aumentare la resistenza nello stato On. Un funzionamento stabile senza fluttuazioni della resistenza nello stato On è il risultato anche del posizionamento ottimizzato dell'SBD.
Attualmente, la famiglia è composta da MOSFET SiC da 650 e 1200 V progettati per applicazioni industriali ad alta potenza, come alimentatori c.a./c.c. da 400 e 800 V, inverter fotovoltaici e convertitori c.c./c.c. bidirezionali per gruppi di continuità (UPS). Sia i MOSFET SiC da 650 V sia quelli da 1200 V sono offerti nel contenitore TO-247 a tre conduttori standard del settore (Figura 5).
 Figura 5: Alloggiati in un contenitore standard TO-247, i MOSFET SiC di terza generazione da 650 e 1200 volt di Toshiba sono adatti a un'ampia gamma di applicazioni di conversione, controllo e gestione della potenza. (Immagine per gentile concessione di Toshiba)
Figura 5: Alloggiati in un contenitore standard TO-247, i MOSFET SiC di terza generazione da 650 e 1200 volt di Toshiba sono adatti a un'ampia gamma di applicazioni di conversione, controllo e gestione della potenza. (Immagine per gentile concessione di Toshiba)
In questi MOSFET SiC di terza generazione, la FoM RDSOn × Qg è ridotta dell'80% rispetto ai dispositivi di seconda generazione di Toshiba - un calo significativo - mentre la perdita di commutazione è ridotta del 20% circa. La tecnologia del diodo a barriera di Schottky incorporato offre inoltre una tensione diretta (VF) ultrabassa.
Esistono altre particolarità di progettazione associate ai MOSFET. Prendiamo ad esempio la VGSS, ossia la tensione massima che può essere applicata tra il gate e il source mentre il drain e il source sono cortocircuitati. Per i dispositivi SiC di terza generazione, l'intervallo VGSS è compreso tra 10 e 25 V, con 18 V come valore consigliato. Gli ampi valori nominali di VGSS facilitano la progettazione e ne migliorano l'affidabilità.
Inoltre, la bassa resistenza e una tensione di soglia di gate più elevata (VGS(th)) – la tensione alla quale il canale del MOSFET inizia a condurre – aiutano a prevenire malfunzionamenti, come l'accensione accidentale dovuta a picchi, glitch e sovraelongazione. Questa tensione varia da 3,0 a 5,0 V, contribuendo a garantire prestazioni di commutazione prevedibili con una deriva minima e semplificando la progettazione del gate driver.
Uno sguardo ravvicinato ai MOSFET SiC di terza generazione da 650 e 1200 V
Un'occhiata a due dispositivi agli estremi opposti della famiglia, quello da 650 e quello da 1200 V, mostra le loro capacità. Il contenitore fisico, la piedinatura e il simbolo schematico sono tutti uguali (Figura 6), ma le specifiche differiscono.
 Figura 6: Tutti i componenti della famiglia di MOSFET SiC di terza generazione di Toshiba hanno la stessa disposizione fisica e lo stesso simbolo schematico; si noti il diodo a barriera di Schottky integrato nel simbolo. (Immagine per gentile concessione di Toshiba)
Figura 6: Tutti i componenti della famiglia di MOSFET SiC di terza generazione di Toshiba hanno la stessa disposizione fisica e lo stesso simbolo schematico; si noti il diodo a barriera di Schottky integrato nel simbolo. (Immagine per gentile concessione di Toshiba)
TW015N65C è un dispositivo di 650 V a canale N da 100 A e 342 W. I valori di specifica tipici sono una capacità di ingresso (CISS) di 4.850 pF, una bassa carica di ingresso gate (Qg) di 128 nC e una RDSOn nominale di soli 15 mΩ.
Oltre alle tabelle dei valori minimi, tipici e massimi per i parametri statici e dinamici, la scheda tecnica presenta grafici che mostrano le prestazioni dei parametri critici rispetto a fattori quali la temperatura, la corrente di drain e la tensione di gate-source (VGS). Ad esempio, il valore di RDSOn in funzione della temperatura, della corrente di drain (ID) e della tensione di gate-source VGS è mostrato nella Figura 7.
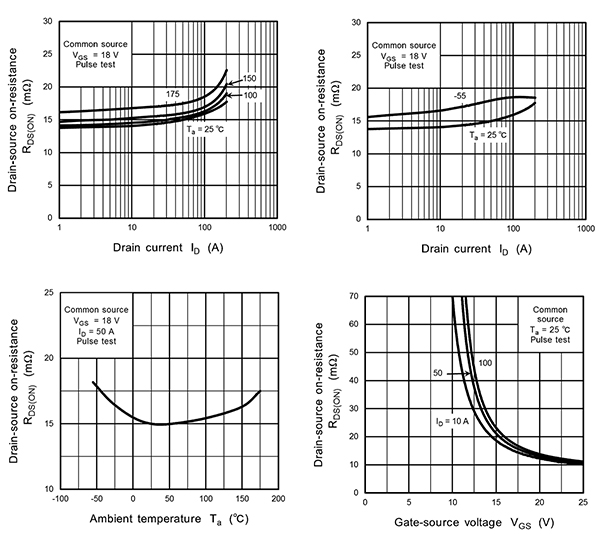 Figura 7: I grafici mostrano la resistenza nello stato On di TWO15N65C da diversi punti di vista, tra cui la corrente di drain, la temperatura ambiente e la VGS. (Immagine per gentile concessione di Toshiba)
Figura 7: I grafici mostrano la resistenza nello stato On di TWO15N65C da diversi punti di vista, tra cui la corrente di drain, la temperatura ambiente e la VGS. (Immagine per gentile concessione di Toshiba)
La stessa serie di specifiche e grafici è mostrata nella Figura 8 per i dispositivi a 1200 V, come TW140N120C, un dispositivo a canale N da 20 A e 107 W. Questo MOSFET SiC presenta una bassa CISS di 6000 pF, una carica di ingresso gate (Qg) di 158 nC e una RDSOn di 140 mΩ.
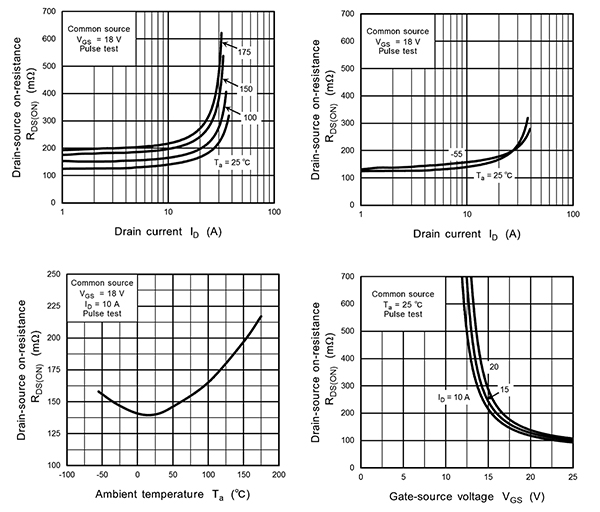 Figura 8: Grafici di caratterizzazione della resistenza nello stato On di TW140N120C. (Immagine per gentile concessione di Toshiba)
Figura 8: Grafici di caratterizzazione della resistenza nello stato On di TW140N120C. (Immagine per gentile concessione di Toshiba)
I dieci MOSFET SiC di terza generazione di Toshiba disponibili comprendono cinque dispositivi a 650 V e cinque a 1200 V. A 25 °C, hanno i seguenti valori di resistenza nello stato On, corrente e potenza:
650 V:
- 15 mΩ, 100 A, 342 W (TWO15N65C)
- 27 mΩ, 58 A, 156 W
- 48 mΩ, 40 A, 132 W
- 83 mΩ, 30 A, 111 W
- 107 mΩ, 20 A, 70 W
1200 V:
- 15 mΩ, 100 A, 431 W
- 30 mΩ, 60 A, 249 W
- 45 mΩ, 40 A, 182 W
- 60 mΩ, 36 A, 170 W
- 140 mΩ, 20 A, 107 W (TW140N120C)
Conclusione
I MOSFET al carburo di silicio offrono un miglioramento significativo dei parametri critici di commutazione rispetto ai dispositivi al solo silicio. Rispetto alle generazioni precedenti, i componenti SiC di terza generazione offrono specifiche e FoM migliori, maggiore affidabilità, migliore caratterizzazione dei requisiti del gate driver e maggiore comprensione delle inevitabili particolarità di progettazione. Utilizzando questi MOSFET SiC, i progettisti di sistemi di potenza hanno a disposizione un'ulteriore risorsa per ottenere una maggiore efficienza, dimensioni ridotte e migliori prestazioni complessive.

Esonero della responsabilità: le opinioni, le convinzioni e i punti di vista espressi dai vari autori e/o dai partecipanti al forum su questo sito Web non riflettono necessariamente le opinioni, le convinzioni e i punti di vista di DigiKey o le sue politiche.








